半導体製造工程
大津電子株式会社の半導体製造工程
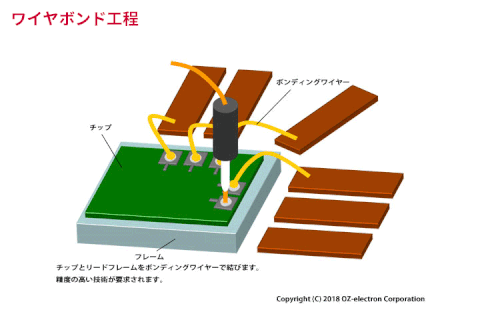
ワイヤボンド工程
半導体チップ表面上に形成されたアルミ電極(約80μmX80μmなど)と、半導体チップを固定するリードフレームのインナーリードとの間を、直径数十μm(主として18~25μm)の金属細線で結線する工程です。
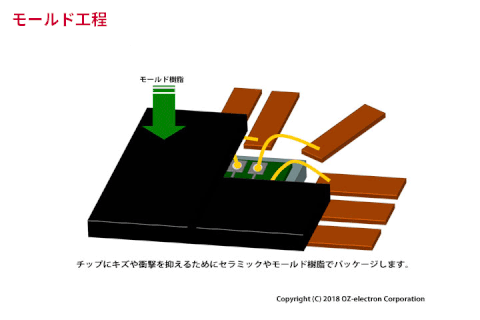
モールド工程
熱硬化性エポキシ樹脂を用いてチップ、ワイヤを保護する工程
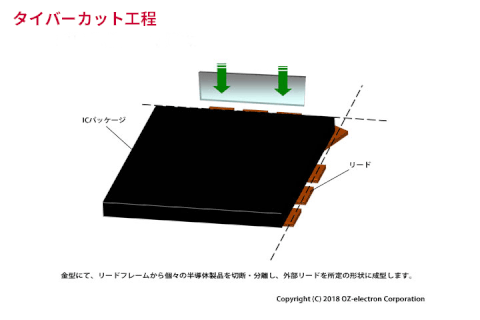
タイバーカット工程
モールド工程で使用している樹脂が外部リードへ漏れ出さないためのダムの役割であるタイバー(又はダムバー)とパッケージ4角の宙吊り部(ピンチカット部)を切断する工程です。
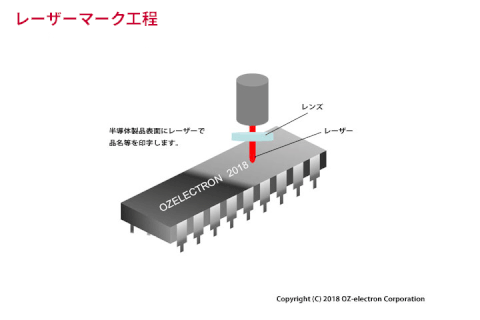
レーザーマーク工程
IC パッケージに以下に示す情報を印字し、製品の識別やロットトレースを行うための加工を行う工程です。
⑴顧客商標/トレードマーク
⑵製品名称
⑶顧客パーツ№
⑷製造ロット№
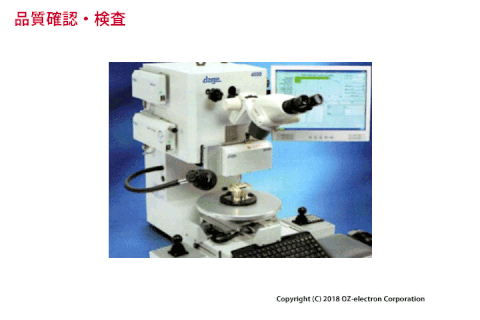
品質確認・検査
最先端評価技術で製品を支え、完成したICの品質を保証する。
お問い合わせ先:
大津電子株式会社
TEL: (096) 293 5050 FAX:(096)293 5899
住所: 熊本県菊池郡大津町大津241
